如今igbt芯片的工艺
2021-07-12
现阶段igbt模块封装的研究具体聚集在新型互接材料、互接方式等有关技术参数优化等,主要是为了能提升模块的散热功能、减少容积,并且提升可靠性。
①芯片表层互接技术igbt模块内部常见引线键合的办法将芯片与芯片、芯片与绝缘衬板表层金属化层、半导体绝缘衬板间和绝缘衬板与功率端子间进行电气互接。常见的键合线有铝线和铜线2种。
 当中铝线键合技术完善、成本较低,但铝线键合的电气、热力学性能较弱,膨胀系数失配大,干扰igbt使用期限。而铜线键合技术具备电气、热力学性能优异等优势,可靠性高,可用于高功率密度、高效散热的模块。但铜键合技术的难题是需用对芯片表层进行铜金属化处理,并且需用更高的超声能量,这有可能损害igbt芯片。
当中铝线键合技术完善、成本较低,但铝线键合的电气、热力学性能较弱,膨胀系数失配大,干扰igbt使用期限。而铜线键合技术具备电气、热力学性能优异等优势,可靠性高,可用于高功率密度、高效散热的模块。但铜键合技术的难题是需用对芯片表层进行铜金属化处理,并且需用更高的超声能量,这有可能损害igbt芯片。
引线键合技术相对技术简单、成本低廉;但也具有缺陷,如多条引线串联的邻近效应会导致电流分布不均匀,寄生电感过大会导致较高的关断过电压,金属引线和半导体芯片间热膨胀失配会形成热应力,进而干扰使用期限等。
为了能避免这些缺陷,研究人员研发出其它新型芯片表层互接技术:直接电极引出和柔性PCB技术。
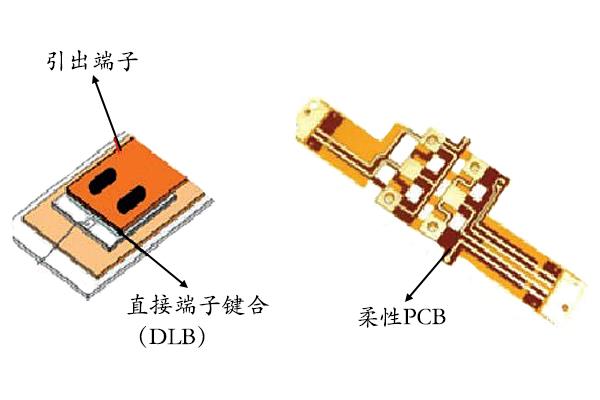 ②贴片互接技术贴片互接是指将芯片下表层与绝缘衬板焊接在一块的互接技术。软钎焊接是常见的贴片焊接工艺,使用焊膏或焊片作为焊料、真空回流焊接工艺,优势是技术简单、成本较低。
②贴片互接技术贴片互接是指将芯片下表层与绝缘衬板焊接在一块的互接技术。软钎焊接是常见的贴片焊接工艺,使用焊膏或焊片作为焊料、真空回流焊接工艺,优势是技术简单、成本较低。
使用软钎焊技术的焊接层熔点在220℃左右,而混合动力电动汽车中igbt芯片可能工作在175℃,焊接层热负荷过重、模块可靠性低。
为之业界研发出了低温银烧结贴片互接技术,焊料使用纳米或微米级银颗粒。
使用这类技术的焊接层具备高热导率、高电导率、高可靠性的优势,但技术实施环节中需用增加高温、高压,材料成本较高,且对设施与工装均提出了较高规定。
以上就是传承电子对如今igbt芯片的工艺的介绍。传承电子是一家以电力电子为专业领域的功率半导体模块制造商,为众多的企业公司提供功率半导体模块的定制、生产和加工,同时还给众多公司提供来料代工或贴牌加工业务。主要产品为各种封装形式的绝缘式和非绝缘式功率半导体模块、各种标准和非标准的功率半导体模块等。
①芯片表层互接技术igbt模块内部常见引线键合的办法将芯片与芯片、芯片与绝缘衬板表层金属化层、半导体绝缘衬板间和绝缘衬板与功率端子间进行电气互接。常见的键合线有铝线和铜线2种。

引线键合技术相对技术简单、成本低廉;但也具有缺陷,如多条引线串联的邻近效应会导致电流分布不均匀,寄生电感过大会导致较高的关断过电压,金属引线和半导体芯片间热膨胀失配会形成热应力,进而干扰使用期限等。
为了能避免这些缺陷,研究人员研发出其它新型芯片表层互接技术:直接电极引出和柔性PCB技术。
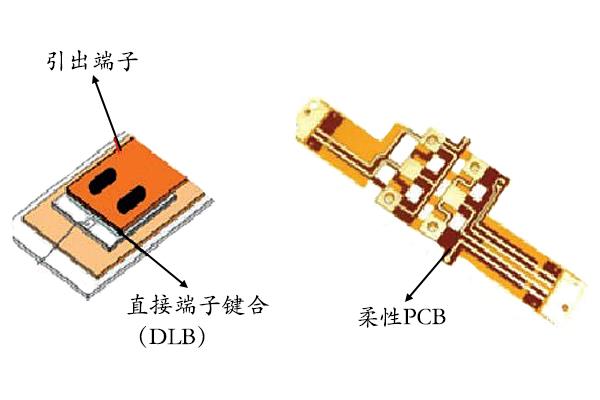
使用软钎焊技术的焊接层熔点在220℃左右,而混合动力电动汽车中igbt芯片可能工作在175℃,焊接层热负荷过重、模块可靠性低。
为之业界研发出了低温银烧结贴片互接技术,焊料使用纳米或微米级银颗粒。
使用这类技术的焊接层具备高热导率、高电导率、高可靠性的优势,但技术实施环节中需用增加高温、高压,材料成本较高,且对设施与工装均提出了较高规定。
以上就是传承电子对如今igbt芯片的工艺的介绍。传承电子是一家以电力电子为专业领域的功率半导体模块制造商,为众多的企业公司提供功率半导体模块的定制、生产和加工,同时还给众多公司提供来料代工或贴牌加工业务。主要产品为各种封装形式的绝缘式和非绝缘式功率半导体模块、各种标准和非标准的功率半导体模块等。
上一篇:可控硅的触发水平检验说明
下一篇:可控硅模块的选择方法
关注微信公众号,了解更多资讯









